在金属电沉积过程中, 常常出现晶面择优取向(织构), 即相当数量的晶粒表现出某种共同的取向特征。如果晶粒的取向高度集中于某一方向, 则称为高择优取向。高择优取向的镀层具有独特的性能, 如Cu(111)[1-2]、Zn(110)[3-4]和MgO(111)[5-6]择优取向的镀层具有更好的抗腐蚀性能, 不同取向的Cu镀层的抗拉强度和延伸率也各有所不同, 高择优取向的BiFeO3薄膜具有良好的铁磁性能[7-9]。因此, 制备高择优取向的金属镀层一直受到关注。
铜沉积层的织构与电解液的组成和电流密度等电解条件密切相关。在CuSO4酸性溶液中, 不加添加剂可以制备出(220)和(111)晶面高择优取向Cu镀层[10], 加入添加剂PEG和Cl-有利于(220)晶面择优取向。采用含有硫脲添加剂的硫酸盐电沉积体系可以制备出(220)面择优取向的Cu镀层, 含有明胶则制备出择优取向的Cu镀层。镀铜的电解液中, 有机添加剂主要有促进剂(如MPS、SPS)和抑制剂(如PEG)。钟琴等[11]研究了MPS和SPS对铜电沉积的影响, 但对在这些添加剂作用下Cu镀层的晶面取向却少有研究。因此, 笔者研究了在CuSO4酸性溶液中分别加入MPS和SPS及其与PEG和Cl-不同组合对铜镀层晶面择优的影响, 制备出全择优取向的(220)铜镀层, 并应用X射线衍射实验研究了铜镀层织构与电流密度的关系。
1 实验 1.1 样品制备酸性CuSO4镀液组成:280 g/L CuSO4·5H2O, 80 g/L H2SO4;添加剂及质量浓度:0.010 g/L MPS, 0.010 g/L SPS, 0.030 g/L PEG(聚合度6000), 0.020 g/L Cl-(NaCl)。所用试剂均为分析纯, 溶液用二次蒸馏水配制。
电沉积条件:镀液温度为30 ℃, 纯铜片为阳极, 铜箔片为阴极, 工作面积1×1 cm2 (双面镀), 电沉积时镀液空气搅拌。电镀前, 铜箔依次经过除油、丙酮和乙醇处理, 再经水洗后用二次蒸馏水冲洗干净, 控制电流密度及电沉积时间, 使得到的Cu镀层厚度基本一致, 约为30 μm。
1.2 铜沉积层的XRD(X-射线衍射)测试获得的Cu镀层进行XRD测试确定镀层的晶体取向。XRD实验在日本理学RIGAKU公司生产的D/max-RC转靶X射线仪上进行, 实验条件为:Cu靶, 管电压40 kV, 管电流30 mA, 狭缝1°DS-1°SS-0.15 mmRS, 以石墨单色器滤波, 扫描速度8°/min, 所有衍射谱都经过Kα1、Kα2分离。
以晶面(hkl)的织构系数TC(Texture Coefficient)来表征晶面择优程度, 计算公式见式(1)[12]。TC值越大, 表明晶面择优程度越高, 一般TC值90%以上称为高择优取向, 100%称为全择优取向。
| $ {\rm{T}}{{\rm{C}}_{{\rm{hkl}}}} = \frac{{{I_{\left( {{\rm{hkl}}} \right)}}/{I_{0\left( {{\rm{hkl}}} \right)}}}}{{\sum {{I_{\left( {{\rm{hkl}}} \right)}}/{I_{0\left( {{\rm{hkl}}} \right)}}} }} \times 100\%, $ | (1) |
式中I(hkl), I0(hkl)分别为沉积层试样和标准铜粉末(hkl)晶面的衍射强度。当各衍射面的TC值相同时, 晶面取向是无序的;如果某一晶面(hkl)的TC值大于平均值1/n时(n为计算时所取的晶面数), 则该晶面为择优取向面, 其取向垂直于基体表面。
2 结果与讨论 2.1 结果 2.1.1 添加剂MPS及其与PEG、Cl-共同作用下的镀层取向在5种电解液中制备镀层, 电解液的添加剂组合情况见表 1, 其质量浓度见1.1。
| 表 1 酸性CuSO4溶液及其含MPS等添加剂组合的电解液 |
在0.040 A/cm2下, 添加剂MPS及其与PEG、Cl-共同作用下镀层的XRD谱线如图 1所示。按照式(1)计算出的镀层各晶面的TC值如表 2所示。没有任何添加剂的镀液电沉积镀层的XRD谱线见图 1中的1谱线, 镀层的(111)晶面的衍射强度最大, 单独加入MPS, (111)面的衍射强度迅速降低, 而(220)的择优程度最大, TC220由不加添加剂的17.80%提高到了52.55%;添加MPS+PEG, TC220变为41.47%。在MPS和MPS+PEG中加入Cl-, (220)择优取向反而较不加Cl-降低, 即添加MPS+Cl-和MPS+PEG+Cl-, TC220分别下降为6.38%和19.92%。与此同时, TC200增大, 由不加添加剂的28.67%提高到了50.12%;添加MPS+PEG+Cl-, TC200成为43.18%。不同添加剂组合都使TC111降低。低电流密度下, MPS和MPS+PEG有利于(220)取向的择优, 在其中加入Cl-, 有利于TC200的择优取向, 但是都达不到高择优取向。
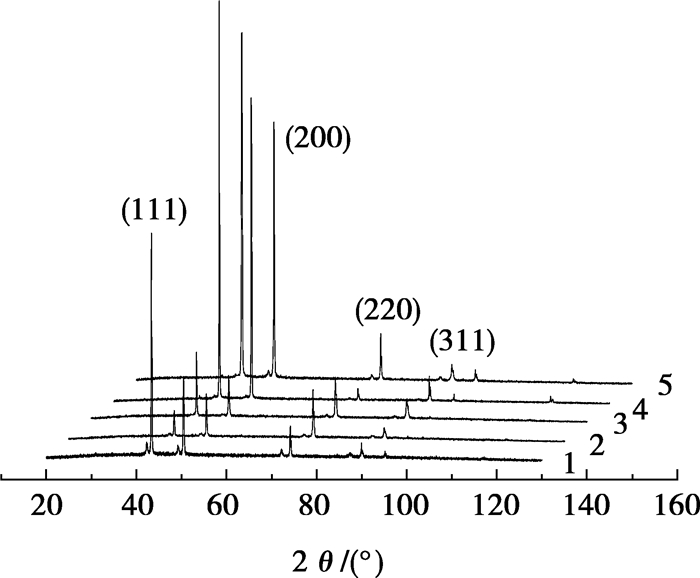
|
图 1 0.040 A/cm2下酸性CuSO4溶液及其含MPS等添加剂组合Cu镀层的XRD图谱 |
| 表 2 0.040 A/cm2下酸性CuSO4溶液及其含MPS等添加剂组合Cu镀层各晶面的TC值(%) |
在高电流密度0.150 A/cm2, 添加剂MPS及其与PEG、Cl-共同作用下镀层的XRD谱线如图 2所示, 按照式(1)计算出的镀层各晶面的TC值如表 3所示。添加MPS+Cl-得到了(220)全择优取向的Cu镀层, 单独加入MPS, TC220由不加添加剂的27.06%提高到了57.94%, 添加MPS+Cl-, TC220达到100%, 即得到全择优的镀层。添加剂改变每个晶面的取向程度, 每种添加剂组合对晶面取向作用完全不同。添加MPS+PEG, TC200由不加添加剂的22.73%提高到57.51%;添加MPS+PEG+Cl-, TC200变为61.77%。添加剂使TC111、TC311降低。

|
图 2 0.150 A/cm2下酸性CuSO4溶液及其含MPS等添加剂组合Cu镀层的XRD图谱 |
| 表 3 0.150 A/cm2下酸性CuSO4溶液及其含MPS等添加剂组合Cu镀层各晶面的TC值(%) |
对比高、低不同电流密度下不同电解液得到的Cu镀层取向, 可以看出:相同电流密度下, 电解液的组成不同, 得到的Cu镀层其择优取向是不同的, 反之亦然。要得到高择优Cu镀层, 添加剂和电流密度的影响同样重要。
2.1.2 添加剂SPS及其与PEG、Cl-共同作用下的镀层取向在5种电解液中制备镀层, 电解液的添加剂组合情况见表 4, 其质量浓度见1.1。
| 表 4 酸性CuSO4溶液及其含SPS等添加剂组合的电解液 |
在0.040 A/cm2下, 添加剂SPS及其与PEG、Cl-共同作用下镀层的XRD谱线如图 3所示, 按照式(1)计算出的镀层各晶面的TC值如表 5所示。在低电流密度0.040 A/cm2, 没有择优取向, 但是添加剂改变每个晶面的取向程度, 每种添加剂组合的晶面取向完全不同。在低电流密度0.040 A/cm2下单独添加SPS, 使(220)取向程度从不加添加剂的17.80%增大到66.45%;添加SPS+PEG使得(220)取向程度增加到43.63%。对比表 2和表 5可知, SPS和MPS及其与PEG作用对Cu镀层取向的影响非常类似。添加SPS+Cl-和SPS+PEG+Cl-, TC200由不加添加剂的28.67%分别提高到了48.69%和55.58%。但添加剂使TC111降低。这个规律也与MPS体系类似。

|
图 3 0.040 A/cm2下酸性CuSO4溶液及其含SPS等添加剂组合Cu镀层的XRD图谱 |
| 表 5 0.040 A/cm2下酸性CuSO4溶液及其含SPS等添加剂组合Cu镀层各晶面的TC值(%) |
在高电流密度0.150 A/cm2下添加剂SPS及其与PEG、Cl-共同作用下镀层的XRD谱线如图 4所示, 按照式(1)计算出的镀层各晶面的TC值如表 6所示。在高电流密度0.150 A/cm2, 单独添加SPS, TC220由不加添加剂的27.06%提高到了38.25%, 添加SPS+Cl-, (220)的取向程度达到了100%, 即得到了全择优的镀层。添加SPS+PEG和SPS+PEG+Cl-, TC200由不加添加剂的22.73%分别提高到34.79%和61.80%。添加剂使TC111、TC311降低。

|
图 4 0.150 A/cm2下酸性CuSO4溶液及其含SPS等添加剂组合Cu镀层的XRD图谱 |
| 表 6 0.150 A/cm2下酸性CuSO4溶液及其含SPS等添加剂组合Cu镀层各晶面的TC值(%) |
不加添加剂, 厚度要达到102.7 μm, TC110才能够达到100%[13]。在高电流密度0.150 A/cm2下添加MPS+Cl-和SPS+Cl-得到了在镀层厚度约为30 μm(220)全择优取向的Cu镀层, 这表明适当的添加剂可以使择优取向提前。
几何选择理论认为, 择优取向是由于不同晶面的生成速度不同所造成的。通常由于晶面生长的速度不同, 快生长的晶面趋于消失, 慢生长的晶面则保留下来, 随着电沉积的继续, 显露于镀层表面的具有慢生长晶面的晶粒所占的比例增大, 于是在电结晶的最后阶段就出现择优取向现象[10, 14-15]。单独添加MPS使(220)取向程度从不加添加剂的17.80%增大到52.55%, 充分说明MPS吸附于Cu的(220)晶面, 阻止该晶面的生长, 导致该晶面成为保留面。MPS与PEG或/和Cl-的相互作用同样导致(220)晶面生长受阻。MPS与PEG或/和Cl-的作用与电流密度有很大的关系, 高电流密度下, MPS+Cl-吸附(220)晶面作用最强, 导致TC220达到100%, 即得到全择优的镀层, SPS+Cl-亦得到全择优镀层[16]。但低电流密度下, 添加剂MPS+Cl-反而使(220)取向程度降低, 由没有添加剂的17.80%降为6.38%, SPS+Cl-作用类似。
3 结论添加SPS、MPS及其与PEG和/或Cl-组合可以提高Cu(220)晶面的取向, 取向程度与添加剂的组合有关, 也与电流密度有关。低电流密度0.040 A/cm2下, 虽然Cu(220)晶面取向度增大, 但是得不到高择优取向。在高电流密度0.150 A/cm2下添加MPS+Cl-和SPS+Cl-, 在厚度约为30 μm得到了(220)全择优取向的Cu镀层, 证明了优化添加剂组合是在电沉积过程中尽早实现高择优取向生长的有效方法。
金属镀层晶面的择优取向受多种因素的影响, 研究各种因素对镀层晶面取向的影响, 了解晶面取向随这些因素的变化规律, 最终实现高择优薄镀层是今后的研究方向。
| [1] |
方华, 丁俊杰, 姜赫.
不同晶面择优取向铜镀层在氯化钠溶液中的耐腐蚀性[J]. 电镀与涂饰, 2013, 32(1): 42–44.
FANG Hua, DING Junjie, JIANG He. Corrosion resistance of copper coatings with different preferred orientations in sodium chloride solution[J]. Electroplating & Finishing, 2013, 32(1): 42–44. (in Chinese) |
| [2] | Zhang M Z, Wang Y, Yu G W, et al. Formation of copper electrodeposits on an untreated insulating substrate[J]. Journal of Physics, 2004, 16(4): 16–19. |
| [3] |
杜楠, 舒伟发, 赵晴, 等.
(110)晶面全择优取向镀锌层的制备及其耐腐蚀性能[J]. 中国有色金属学报, 2013, 23(2): 426–433.
DU Nan, SHU Weifa, ZHAO Qing, et al. Preparation of zinc electrodeposits with (110) lattice plane fully preferred orientation and its corrosion resistance[J]. The Chinese Journal of Nonferrous Metals, 2013, 23(2): 426–433. (in Chinese) |
| [4] | Hae S C, Hyeong J K. Effects of additives on the preferred orientation of Mn-Zn ferrite thin films deposited by ion beam sputtering[J]. Applied Physics Letters, 1995, 66(10): 1282–1284. DOI:10.1063/1.113270 |
| [5] |
崔荣洪, 于志明, 何宇廷, 等.
超声电沉积铜薄膜的耐腐蚀性能研究[J]. 腐蚀科学与防护技术, 2010, 22(3): 169–172.
CUI Ronghong, YU Zhiming, HE Yuting, et al. Study on corrosion resistance for ultrasonic electrodeposition of copper film[J]. Corrosion Science and Protection Technology, 2010, 22(3): 169–172. (in Chinese) |
| [6] |
曹晓燕, 叶辉.
溶胶凝胶生长(111)择优取向的MgO薄膜[J]. 浙江大学学报:工学版, 2005, 39(4): 461–464.
CAO Xiaoyan, YE Hui. Growth of highly (111) orientated MgO films by Sol-Gel method[J]. Journal of Zhejiang University:Engineering Science, 2005, 39(4): 461–464. (in Chinese) |
| [7] | Chen Y, Miao J, Zhang X. Enhanced electric and magnetic properties of the epitaxial (Ba0.5Sr0.5)TiO3/BiFeO3 multiferroic heterostructure[J]. IEEE Transactions on Magnetics, 2012, 48(11): 3418–3421. DOI:10.1109/TMAG.2012.2200459 |
| [8] | Cheng M, Tan G, Xia A, et al. Preparation and electrical properties of BiFeO3 films on FTO/glass substrate by chemical solution deposition[J]. Journal of Functional Materials, 2012, 43(2): 250–252. |
| [9] | Wang Y, Li Z, Lin Y H, et al. Magnetic-electric behaviors in BiFeO3films grown on LaNiO3-buffered Si substrate[J]. Journal of Applied Physics, 2009, 106: 073917–073924. DOI:10.1063/1.3240327 |
| [10] |
辜敏, 杨防祖, 黄令, 等.
高择优取向Cu电沉积层的XRD研究[J]. 电化学, 2002, 8(3): 282–287.
GU Min, YANG Fangzu, HUANG Ling, et al. XRD study on highly preferred orientation Cu electrodeposit[J]. Electrochemistry, 2002, 8(3): 282–287. (in Chinese) |
| [11] |
钟琴, 辜敏, 李强.
添加剂3-巯基-1-丙烷磺酸钠对铜电沉积影响的研究[J]. 化学学报, 2010, 68(17): 1707–1712.
ZHONG Qin, GU Min, LI Qiang. Studies on the influence of sodium 3-mercaptopropanesulphonate additives on copper electrodeposition[J]. Acta Chimica Sinica, 2010, 68(17): 1707–1712. (in Chinese) |
| [12] |
王震东, 赖珍荃, 范定环, 等.
高择优取向Mo薄膜的直流磁控溅射制备及其电学性能[J]. 光子学报, 2011, 40(9): 1342–1345.
WANG Zhendong, LAI Zhenquan, FAN Dinghuan, et al. Fabrication and electrical properties of highly preferred orientation Mo thin film by DC magnetron sputtering[J]. Acta Photonica Sinica, 2011, 40(9): 1342–1345. (in Chinese) |
| [13] |
辜敏, 杨防祖, 黄令, 等.
高择优取向铜镀层的电化学形成及其表面形貌[J]. 物理化学学报, 2002, 18(11): 973–978.
GU Min, YANG Fangzu, HUANG Ling, et al. The formation of copper electrodeposits with highly preferred orientation and their surface morphology[J]. Acta Physico-chimica Sinzca, 2002, 18(11): 973–978. DOI:10.3866/PKU.WHXB20021103 (in Chinese) |
| [14] | ZHANG Q B, Hua Y X. Effects of[HMIM]HSO4 and[OMIM]HSO4 on the electrodeposition of zinc from sulfate electrolytes[J]. Journal of Applied Electrochemistry, 2009, 39(8): 1185–1192. |
| [15] | ZHANG Q B, Hua Y X. Effects of 1-butyl-3-methylimidazolium hydrogen sulfate-[BMIM]HSO4 on zinc electrodeposition from acidic sulfate electrolyte[J]. Journal of Applied Electrochemistry, 2009, 39(2): 261–267. |
| [16] |
张桂凯, 李炬, 陈长安, 等.
HR-2钢表面在AlCl3-EMIC熔盐中电沉积铝镀层的织构和形貌[J]. 稀有金属材料与工程, 2010, 39(1): 81–85.
ZHANG Guikai, LI Ju, CHEN Changan, et al. Preferred orientation and their surface morphology of aluminium coatings electrodeposited on HR-2 steel in AlCl3-EMIC ionic liquid[J]. Rare Metal Materials and Engineering, 2010, 39(1): 81–85. (in Chinese) |
 2014, Vol. 37
2014, Vol. 37


